终端客户在电子胶粘剂的使用中通常会遇到的问题:
今天这篇文章主要是归纳总结一下芯片封装过程中时常会遇到的树脂溢出问题[RBO(Resin Bleeding Out),或称ERO (Epoxy bleed out)]。
随着微电子继续向更小的外形、更高的可靠性和更好的性能发展,RBO的控制对在芯片封装尤其是在多芯片封装变得越来越重要。
RBO简介

将胶粘剂点到基板或粘接界后,树脂从胶粘剂中迁移出来,在芯片周围扩散,形成澄清无色或者琥珀色的有机污染状的环状阴影,如上图.
当树脂严重扩散时会严重影响后续的打线(wire bonding),密封(Sealing ‘molding) 等工艺.
当胶粘剂点到基板框架上,胶水通常会部分湿润基板表面。胶水与基板之间的粘合力导致粘贴扩散,而胶粘剂自身的聚力将保持成分在一起,避免与框架表面接触。
粘合力和凝聚力是相互交际的力量,如氢粘结力和范德瓦尔斯力。因此,湿润程度将取决于粘合力和凝聚力之间的平衡。当配方中的一些成分原料对基材的粘合力强
于粘贴内的凝聚力时,就会RBO。 RBO的驱动力是通过湿润来最大限度地减少基材的表面能量。
目前芯片尺寸越来越小,对RBO容忍度也越来约低

值得注意的是,需要合理区分是RBO还是加热气流的影响,
1.非RBO
2.RBO(均一)
3.RBO(粗糙刻蚀差异)
如图: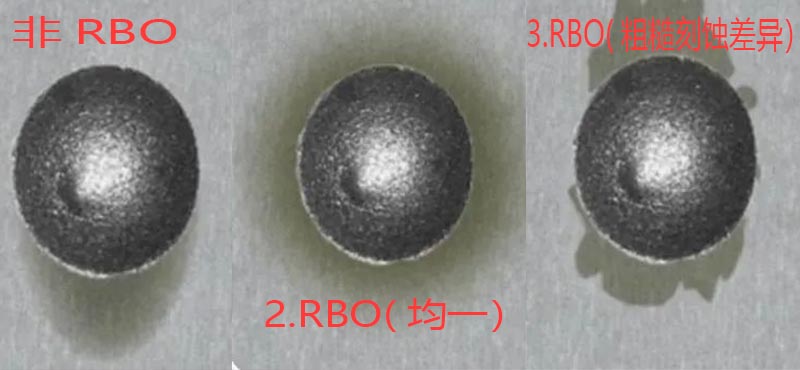
造成RBO原因
导致树脂溢出RBO的原因有很多,包括液体浸润的的热力学原理(表面张力),胶粘剂/基板的性能,以及胶粘剂固化流程等
2.1 基材的表面能/张力差异影响

通常,粘接的基材表面要比胶粘剂的表面能要高,这样才能够很好的润湿基材,达到理想的粘接效果。
即使是同一款胶水, 在不同表面能的基材上的RBO表现不尽相同,尤其是在Au金的界面上,会更加明显.
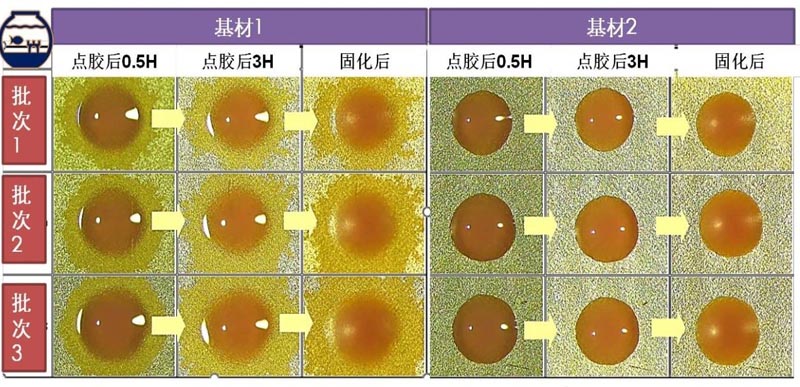
客户端的工艺不同,选择的粘接界面也会多种多样,时常发生彼之蜜糖,我之砒霜(附上一些基板 和树脂的表面张力数据)

2.2 胶粘剂的表面张力影响
胶粘剂通常是由2种或多种树脂混合均匀组成,如果其中一种或几种树脂对基材表面的亲和力大于其自身凝聚力(表面张力),树脂从自身溢出,RBO就会发生。
一般来说,低粘度的胶粘剂会比高粘度的胶粘剂更容易发生RBO,主要是受毛细现象和胶粘剂本身的浸润动力影响,同时,密度差异,树脂高分子的分子量分布,
填料的种类等因素也会影响RBO现象。

补充:表面张力受温度影响,所以当看到表面张力的数值时必须标明所对应的温度,一般情况下,表面张力随着温度的升高而降低,直到某一临界温度时
达到0,所以为什么有些黏合剂,在高温固化的粘接强度比常温固化要好,也跟表面张力更低润湿性更好有关吧。
2.3 胶水固化工艺影响
待续.........